Bondování neboli propojování polovodičových součástek pomocí tavených ultrajemných drátků (Wire Bonding) je vysoce spolehlivou a účinnou metodou. Je však náročné na kvalitu a vlastnosti použitých kovů, jejich homogenní složení a s ním spojené mechanické vlastnosti. Stabilita spoje může být ohrožena působením nadbytečného tepla během procesu pájení drátů na drátěné podložky. To vede k zeslabení spoje, což může ovlivnit jeho stabilitu.
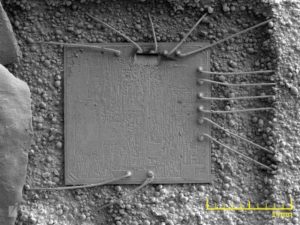
Bondování na polovodičovém čipu po chemické dekapsulaci
- Skenovací elektronová mikroskopie (SEM) umožňuje provádět různé zkoušky mikroskopických spojů. Patentovaná bezclonová technologie Wide Field Optics™ TESCANu umožňuje zobrazit extra velké objekty, jako je například celý čip s odhalenými kontakty při malém zvětšení.
- Vysoce výkonný elektronový tubus MIRA umožňuje nastavit vysoké elektronové proudy, které umožňují pokročilé analytické techniky, jako je EDX nebo WDX. Ty jsou klíčové při metalurgických studiích s ohledem na tvorbu intermetalických vrstev na rozhraní nebo při studiích vlivu distribuce zrn na bondování.
- Systémy TESCAN FIB-SEM rozšiřují analytické možnosti nano- a mikroinženýrství, umožňují průřez vodičem za účelem zhodnocení procesu bondování.
- SEM a FIB analýzy lze také úspěšně využít ke studiu účinku vysokých teplot na bondovací vodiče, jako jsou metalurgické změny, vznik mikroskopických dutin a pokles pevnosti spoje.
- Pro provádění zátěžových testů in situ lze navíc použít TESCAN tahový stolek a nanoindentor.
- Různé průřezy připravené pomocí Xe plasma FIB: Příkop připravený pro 3D tomografii
- Detail spoje vytvořeného bondováním
- Drátky zapuštěné do pryskyřice
- Průřez spojem
- Detail spoje odhalující nežádoucí prasklinu způsobující nefunkčnost