TSV umožňuje integraci heterogenní matrice, která používá různé procesní a výrobní technologie. TSV významně zvyšují šířku pásma mezi logickým čipem a pamětí (zejména u širokého paměťového rozhraní), čehož nelze dosáhnout použitím standardních bondovacích vodičů. Existují však obavy ohledně spolehlivosti TSV; bylo prokázáno, že tepelné cyklování a žíhání může vyvolat mechanické selhání v TSV. Rozdíly v koeficientech tepelné roztažnosti mezi Cu a Si destičkou vedou ke značnému tepelnému namáhání, které má vliv na výkon zařízení. Vytlačování Cu, vyvolané tepelným napětím, může způsobit selhání jak TSV, tak navazujících struktur.
TESCAN může poskytnout polovodičovému a pouzdřícímu průmyslu pestrou škálu systémů a detektorů pro implementaci analytických technik ke studiu úrovní stresu a extruze Cu v TSV. Naše řada vysoce výkonných SEM umožňuje zobrazování vytlačování TSV a fyzickou kontrolu v jeho průřezu ve vysokém a ultravysokém rozlišení. Systémy se dvěma fokusovanými paprsky umožňují přesně určit místa selhání a následnou místní kontrolu a charakterizaci defektů pomocí jediného nástroje. Plazmové systémy TESCAN Xe FIB-SEM nabízejí potřebný výkon a rychlost pro provádění vysoce efektivní analýzy v TSV.
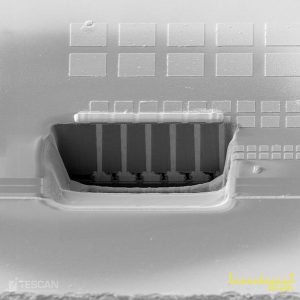
Velká plocha průřezu 3D IC ukazující 5 Cu TSV v křemíku spolu s pájecími kuličkami ve spodní části. Průřez byl připraven za méně než jednu hodinu pomocí Xe Plasma FIBu.
- TSV s délkou od 50 do 100 μm a průměrem od 15 do 30 μm jsou obvykle uspořádány do polí (která mohou být větší než 500 μm), proto realizace průřezu u těchto struktur může být náročná s použitím běžných zdrojů Ga iontů.
- Velké průřezy umožňují vyhledávat a zkoumat dutiny, delaminace, trhliny a jiné závady vyskytující se v TSV.
- Za účelem studia mikrostruktury Cu a různého rozložení zrn lze pomocí EDX a EBSD provádět mapové analýzy v TSV.
- Xe Plasma FIB způsobuje v porovnání s Ga menší amorfní poškození, což je výhoda pro analýzu EBSD.
- BSE pohled v řezu na 2,5D stoh matricí zobrazující dvě Cu TSV, které procházejí křemíkovým mezikusem za účelem připojení horních kovových vrstev k dalším kovovým vrstvám na zadní straně
- Průřez 2,5D stoh matricí ukazující pájecí kuličku a dvě TSV
- Zvětšený obrázek Cu TSV zobrazující pájecí kuličku, pasivační vrstvu, formovací výplň a směsnou vrstvu oxidu
- Horní část TSV zobrazená pomocí SE detektoru
- Spodní část TSV zobrazená BSE detektorem pro zdůraznění kontrastu na hranách zrn
- Mapy EBSD sady 4 × 50 μm měděných TSV, které byly vyleštěny Plasma FIBem. Snímek ukazuje překrytí SE obrazu s orientačními mapami IPF. Obrázek převzat z T.Hrncir, et.al. ISTFA 2014, s. 136.